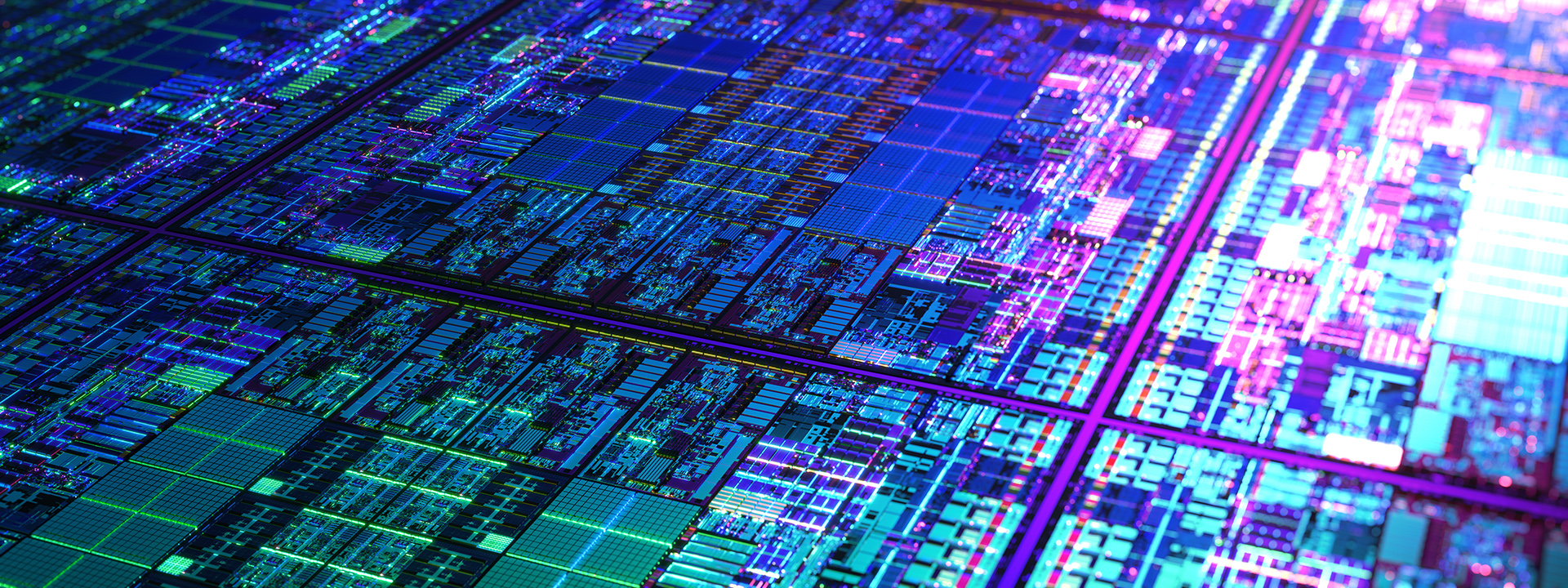

Maximizing Process Efficiency and Yield with High-Performance Metrology Techniques:
A Two-Part Webinar Series
Pick the best metrology technologies for your R&D, process control, failure analysis, and reliability testing needs.
In this on-demand two-part webinar series, you will learn how to apply Bruker’s high‑performance metrology techniques to evaluate and optimize front-end processes, back-end processes, and failure analysis. Our team of application experts use case studies to demonstrate where Bruker’s benchtop and automated metrology solutions can add capability and value.
PART 1:
Accelerating Front-End Semiconductor Process Control with Accurate Metrology and Characterization
Discover how Bruker's benchtop and automated metrology solutions can improve and optimize your semiconductor front-end process control and yield management.
Bruker's high-performance metrology and characterization techniques can provide new insights for your R&D or process control by assisting in the nanometer-scale surface evaluation of semiconductor materials and devices. During Part 1 of this series, our applications experts discuss and demonstrate how each of our core technologies can be applied to the most current technology nodes and wafer processing steps in front end, back end, and failure analysis areas. Presentations include case study examples showcasing the specific uses and advantages of each technology.
PART 2:
Scanning Probe Microscopy and Nano-Indentation for Semiconductor Failure Analysis and Reliability
Part 2 of this series addresses how scanning probe microscopy (SPM) and nanoindentation can advance failure analysis and reliability testing in the semiconductor industry.
SPM, or atomic force microscopy (AFM), is known for its ability to image surface topography with nanoscale spatial resolution, but its capabilities extend much further. By choosing the right probes, modes, and methods, SPM can be adapted to measure a variety of electrical, magnetic, thermal, and mechanical properties. More recently, SPM has also been expanded to enable chemical identification at the nanometer scale using AFM-IR methods. In the first half of this segment, Bruker experts use Si and compound semiconductor device examples to demonstrate how standard topographical AFM imaging and other types of property imaging can be used to inform semiconductor failure analysis and improve reliability.
The second half of this segment focuses on how nanoindentation can be used for quantitative nanomechanical characterization and in-situ (inside the SEM or TEM) direct observation in semiconductor applications. Bruker experts present nanoindentation case studies — including the thermal expansion of Cu-TSVs — to demonstrate our nanomechanical test instruments' broad suite of complementary characterization techniques and how they can be leveraged for semiconductor failure analysis and reliability testing.
