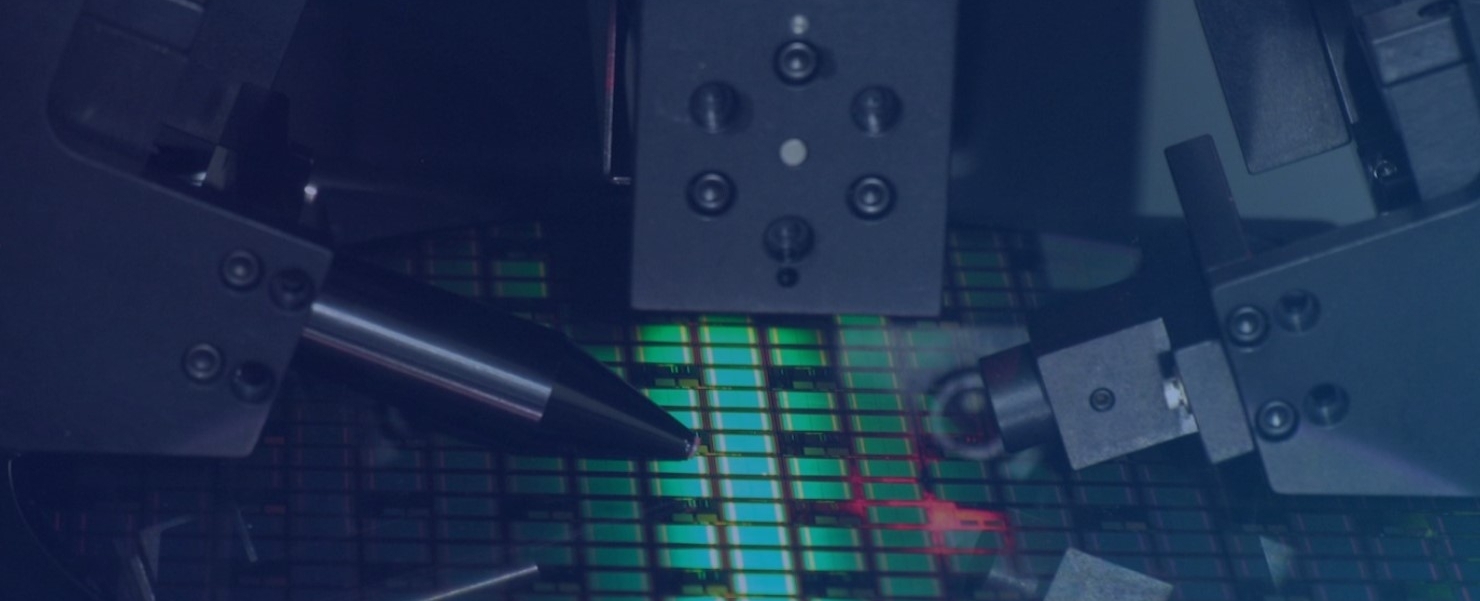
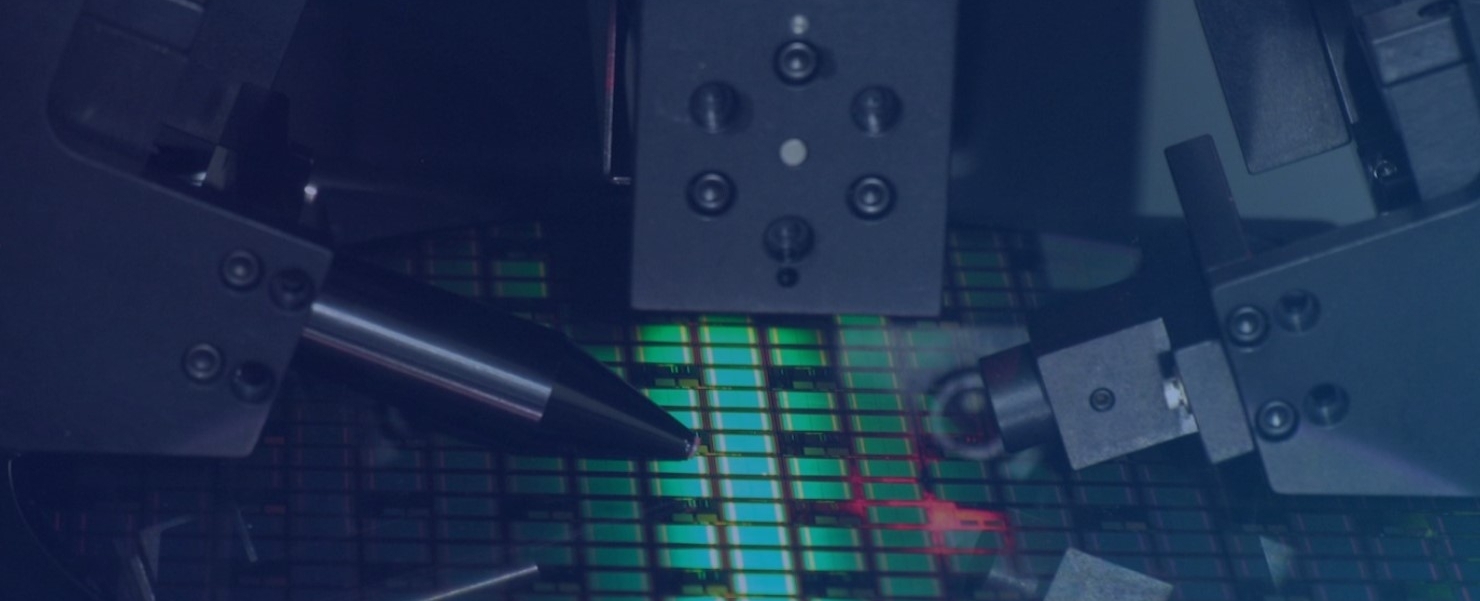
FilmTek 分光エリプソメトリー・反射率測定システム
研究開発から生産までカバーする高度な光学計測ソリューション
非接触光学計測技術に基づいて、FilmTekは複数の角度から様々なデータを同時に取得して、膜厚と屈折率を決定します。異なる入射角から測定することにより、収集されたスペクトル間に波長シフトが生じます。スペクトル間の波長シフトは、フィルムの屈折率とスペクトル間の角度差の関数にすぎません。FilmTekのシステムは、振幅の変化から屈折率情報を抽出するのではなく、波長シフトから屈折率を独立して決定することにより、膜厚と屈折率の測定にクラス最高の性能を発揮します。この独自の技術により、従来のエリプソメトリーや反射率測定の方法では不可能だったアプリケーションに対応します。
装置に関するご相談・お見積については、Brukerの担当者へご相談ください。
あなたに最適な光学計測ソリューションを
自動計測モデル
ベンチトップモデル
まずはお問い合わせください。お客様のアプリケーションに応じ、最適なシステム・オプションをご提案させていただきます。
世界トップクラスの研究所や工業生産現場に設置された弊社の計測機器は、多くの厚膜、薄膜、多層膜の評価において、他の機器では実現できない最高精度と屈折率分解能を誇ります。学術研究や研究開発から管理された環境での大量生産まで、幅広い用途に対応しています。
また、幅広い用途、サンプル、環境に対応するため、FilmTekのシステムは、標準仕様にさまざまなオプション機能を追加することができます。手動の卓上型機器も完全自動の生産ライン対応モデルも、シンプルな計測から複雑な計測まで幅広く対応します。
用途別にソリューションを備えた高度な薄膜計測技術
半導体前工程
半導体の前工程でパターン化されたデバイスウエハ上で、高速かつ正確で再現性の高い多層膜の膜厚と屈折率の測定を行います。
FilmTekシステムは、酸化物、窒化物、ONO、酸化物/窒化物/Cu、ポリシリコン/酸化物、AlN、TaN、TiN、SiGex、レジスト、Si3N4/GaAs、ARC、ゲート酸化膜、GaAs膜、Cu上のCMP、その他ウエハ製造プロセス全体で発生する多くの材料のプロセス制御を可能にします。
おすすめの計測システム:
半導体後工程
半導体の後工程に関係するパラメーターを幅広く測定します。
FilmTekのプロセス制御ソリューションは、バンプの共平面性のためのレジスト厚膜、高アスペクト比のTSVの深さ、インターコネクトのトップCD、ウエハの厚みや平坦度(TTV)の変動、ボンディングプロセスにおける薄い金属酸化物の厚みなどの完全自動測定を可能にし、NWO(non-wet open)不良を防止します。
おすすめの計測システム:
シリコンフォトニクス
プリズムカプラ法よりも10倍優れた性能で、膜厚と屈折率を測定します。
Filmtekの非接触型マルチアングル反射率測定システムは、精密な高分解能測定を実現し、幅広い平面導波路およびシリコンフォトニクス用途(SiON、Si3N4、Ge-SiO2、P-SiO2、BPSG、APOX、HiPOXおよびSiO2/SiON積層膜)のインラインの自動プロセス制御を可能にします。
おすすめの計測システム:
多層薄膜
前工程および後工程のパターン化されたウエハ上の薄膜および多層薄膜について正確で精密な測定が可能です。
Filmtekの先進的なマルチアングル・多測定モードの技術により、薄膜、酸化物/窒化物/銅、CMPプロセスのモニタリング、サブオングストロームの再現性による金属酸化物薄膜(SnO、CuO、InO)の測定が可能になり、ボンディングプロセスにおけるNWO(non-wet open)不良を防止するためのインライン組成制御(SiGexにおけるGe%など)が可能になります。
おすすめの計測システム:
医療用センサーおよびデバイス
バイオアクティブフィルムの正確な厚さ測定により、医療用デバイスおよびセンサーの品質、生産安定性、製品性能を向上させます。
FilmTek薄膜測定システムは、グルコースセンサーの薄膜厚さの自動非接触測定とウエハマッピング、金属JAW表面コーティング厚さのマッピング、使い捨て血液センサー多層膜の厚み測定を可能にします。
おすすめの計測システム:
MEMS
パターン化されたウエハ上の酸化物、窒化物、酸化物/窒化物、ONO、アモルファスカーボン、レジスト、酸化物/ポリシリコン/酸化物の膜厚および屈折率を完全に自動で測定します。
完全自動のFilmTekエリプソメトリーおよび反射率測定ツールは、カセットからカセットへのウエハハンドリング、50µmのスポットサイズ、パターン認識、およびSECS/GEMを特長とし、性能と価格の面で最高の組み合わせを実現しています。
おすすめの計測システム:
透明基板
透明基板上の薄い吸収膜の厚さおよび光学定数を正確に、かつ唯一無二に測定します。
FilmTek反射および透過分光システムは、100Å未満から約150µmまでの厚さのほぼすべての半透明フィルムを、非常に高い精度と再現性で、かつ非接触で光学特性を評価することが可能です。典型的な測定用途は、ITO、NPB、Alq3、Si3N4、SiO2、ポリシリコン、a-Siおよび多層膜です。
おすすめの計測システム:
新素材
幅広い迅速かつ正確で信頼性の高い測定機能により、新素材を特徴づけます。
自動ウエハマッピング機能付きのFilmTek卓上型ツールは、多層膜厚、屈折率[n(λ)]、消衰(吸収)係数[k(λ)]、エネルギーバンドギャップ[Eg]、組成(SiGex中の%Ge、GaxIn1-xAs中の%Ga、AlxGa1-xAs中の%Alなど)、表面粗さ、ボイドの割合、結晶化度/アモルファス化度(例えばPoly-SiやGeSbTe膜の結晶化度)、膜厚分布の測定が可能です。
おすすめの計測システム:
未知・複雑な材料
未知の材料の厚さ(t)、屈折率(n)、消衰係数(k)を独立かつ明確に決定します。
FilmTekの複合型マルチアングル反射率測定と回転補償子設計のエリプソメトリーシステムは、パターン化および非パターン化サンプルの自動マッピングによる高スループット測定、薄膜の0.03オングストロームの再現性、厚膜の測定、複雑な多層薄膜構造のサブオングストローム精度での評価などこれまでにない性能を実現します。
おすすめの計測システム:
当社の技術についてさらに詳しく
どのようなお手伝いが必要ですか?
ブルカーはお客様と協力し、実世界のアプリケーション課題を解決します。次世代技術を開発し、お客様が適切なシステムとアクセサリーを選択できるようサポートします。このパートナーシップは、機器販売後もトレーニングや延長サービスを通じて継続します。
高度な訓練を受けたサポートエンジニア、アプリケーションサイエンティスト、専門知識を持つエキスパートからなるチームが、システムサービスやアップグレード、アプリケーションサポート、トレーニングを通じて、お客様の生産性最大化に全力を尽くします。
専門スタッフのテクニカルサポート
ご質問、資料請求またはブルカーの営業担当者へのご連絡はこちらまで。